【Study】DFM的概念与流程——《集成电路先进光刻技术与版图设计优化》

编者按:中国科学院大学微电子学院是国家首批支持建设的示范性微电子学院。为了提高学生对先进光刻技术的理解,本学期微电子学院开设了《集成电路先进光刻技术与版图设计优化》研讨课。在授课过程中,除教师系统地讲授外,学生还就感兴趣的课题做深入调研。师生共同讨论调研报告,实现教学互动。调研的内容涉及光刻工艺、光刻成像理论、SMO、OPC和DTCO技术。考虑到这些内容也是目前业界关注的实用技术,征得教师和学生的同意,本公众号将陆续展示一些学生的调研结果。这些报告还很初步,甚至有少许谬误之处,请业界专家批评指正。





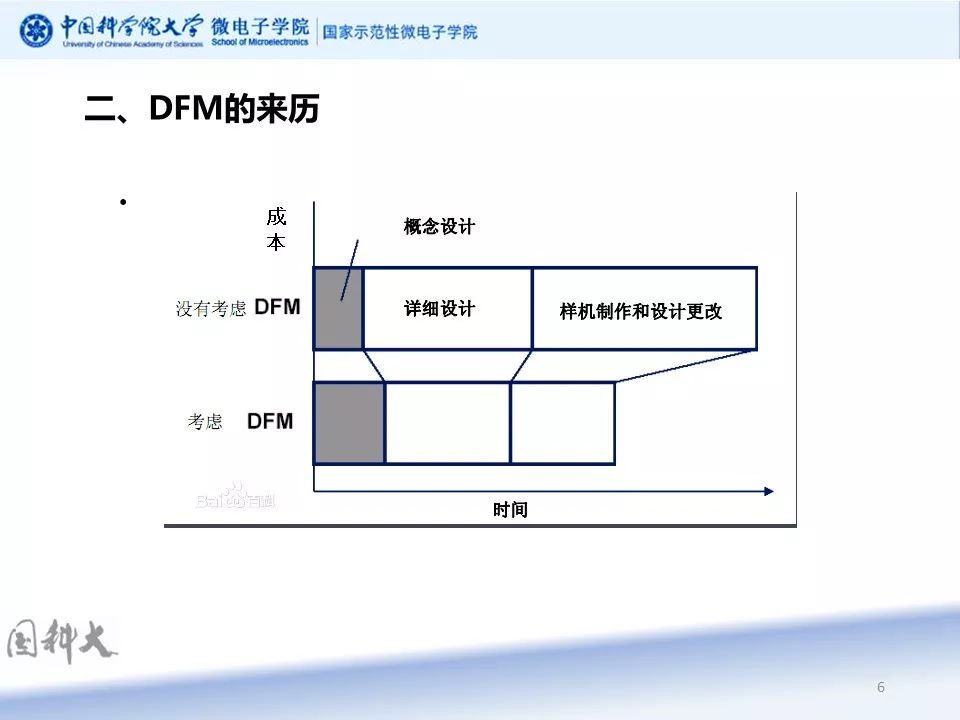



















往期回顾:
1.【litho-show】DTCO中用于坏点检测的人工智能算法
2.【litho-show】几种典型的 DTCO流程对比分析
5.【litho-show】EUV光刻胶当前的发展状态及面临的挑战
6.【litho-show】EUV光刻中的光刻胶随机效应及补偿方案分析
8.【litho-show】新型芯片对光刻的需求 ——以高通骁龙845为例
10.【litho-show】EUV光刻中掩模阴影效应的产生机理及补偿方案分析
11.【litho-show】各种存储器的对比分析及光刻的要求
12.【litho-show】高数值孔径EUV光刻系统的特征分析
28.【Study】极紫外光刻(EUVL)技术的现状,趋势以及面临的挑战
30.【Study】SADP技术的特点及其对图形拆分方法的要求
34.【Study】小尺寸节点下CMP aware的版图优化
35.【Study】考虑了Forbidden Pattern的定向自组装设计规则优化
看完有什么感想?
请留言参与讨论!

如侵权请联系:litho_world@163.com
【欢迎留言,欢迎转发】
半价购买《超大规模集成电路先进光刻理论与应用》,请在公众号后台回复“购书”,或者直接扫码,添加管理员微信。

简介:
《超大规模集成电路先进光刻理论与应用》光刻技术是所有微纳器件制造的核心技术。在集成电路制造中,正是由于光刻技术的不断提高才使得摩尔定律得以继续。本书覆盖现代光刻技术的重要方面,包括设备、材料、仿真(计算光刻)和工艺。在设备部分,对业界使用的主流设备进行剖析,介绍其原理结构、使用方法、和工艺参数的设置。在材料部分,介绍了包括光刻胶、抗反射涂层、抗水涂层、和使用旋图工艺的硬掩膜等材料的分子结构、使用方法,以及必须达到的性能参数。本书按照仿真技术发展的顺序,系统介绍基于经验的光学邻近效应修正、基于模型的光学邻近效应修正、亚分辨率曝光辅助图形、光源-掩模协同优化技术和反演光刻技术。如何控制套刻精度是光刻中公认的技术难点,本书有一章专门讨论曝光对准系统和控制套刻精度的方法。另外,本书特别介绍新光刻工艺研究的方法论、光刻工程师的职责,以及如何协调各方资源保证研发进度。
 扫一扫下载订阅号助手,用手机发文章
扫一扫下载订阅号助手,用手机发文章 
朋友会在“发现-看一看”看到你“在看”的内容