脉冲激光模拟空间载荷单粒子效应研究进展

作者:韩建伟,上官士鹏,马英起
朱翔,陈睿,李赛
摘要:脉冲激光作为模拟测试空间探测载荷半导体器件的单粒子效应现象的一种较新型手段,具有可以定位器件对单粒子效应敏感的具体单元以及动态测试电路系统对单粒子效应的时间响应特性的特点,能够满足工程部门、器件研发部门的不同需求。通过实验与理论研究,建立单粒子锁定与翻转效应的激光阈值能量与重离子LET值的对应关系,解决了脉冲激光模拟测试的激光结果如何定量的关键问题,据此可以定量摸底评估器件的单粒子效应敏感度,使脉冲激光测试载荷的结果更具评价以及指导意义,这对建立统一的脉冲激光单粒子效应评估试验标准以及对脉冲激光试验的推广具有重要意义。空间探测载荷发生单粒子效应后器件功能特性及电路系统的影响、防范单粒子效应电路条件影响的手段下电路系统的抗单粒子效应设计措施的有效性,以及为空间探测专门研制的抗辐射ASIC电路评价,都需要更加精细的单粒子效应测试方法。通过建立便捷、低成本的脉冲激光定量试验的手段,解决了空间探测载荷上述单粒子效应试验的问题。
关键词:空间探测载荷,单粒子效应,脉冲激光,敏感区域定位,动态测试
0. 背景
高性能、高可靠性、高集成度、低功耗、小质量、小尺寸的半导体器件和集成电路在深空探测载荷中的应用需求不断增加,然而航天电子器件在深空环境中会受到银河宇宙线、太阳宇宙线等高能粒子的辐射,引起的单粒子效应严重威胁航天器的安全可靠运行[1,2]。航天器电子器件在应用于深空环境前,需要评估其单粒子效应特性及对电路系统的影响,需要摸索设计合适的电路条件防范单粒子效应的影响,需要试验验证电路系统的抗单粒子效应设计措施,甚至要研制载荷专用的抗辐射ASIC电路,这些都要求更加精细的单粒子效应测试。
中国科学院国家空间科学中心(以下简称空间中心)于2001年在国内开展脉冲激光试验单粒子效应机理与方法研究。脉冲激光试验单粒子效应设备及技术操作便捷、试验机时充裕,试验环境开放无需真空 [3,4,5],便于设计师灵活地测试器件的单粒子效应特性及对电路系统的影响,从而确定合理的单粒子效应防护设计措施;能够准确有效地触发单粒子锁定、单粒子翻转、单粒子烧毁、单粒子多位翻转、单粒子瞬态脉冲、单粒子功能中断等,便于设计师试验验证其抗单粒子效应设计措施是否有效。通过研究确定激光单粒子效应能量与重离子LET值的对应关系,可定量评价器件的单粒子效应敏感度。此外,脉冲激光试验可以方便地定位器件单粒子效应敏感区域[13,14,15,16],获取导致器件单粒子效应的电流脉冲等关键参量[7,8],为载荷研制抗辐射专用ASIC电路提供精细的单粒子效应特征信息参数。
1. 脉冲激光模拟单粒子效应的试验装置
1.1 脉冲激光试验单粒子效应装置原理
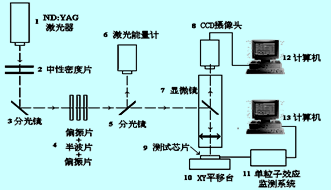
图1 脉冲激光试验单粒子效应装置原理图
Figrue1. Schematic chart of pulsed laser single event effects(PLSEE) Facility
1.2 脉冲激光试验单粒子效应装置
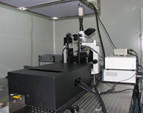
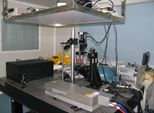
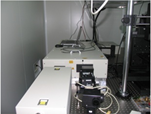
图2 空间中心纳秒(上)、皮秒(中)和飞秒(下)脉冲激光试验单粒子效应装置
Figure 2. Nanosecond (left), Picosecond (middle) andFemtosecond (right) PLSEE of National Space Science Center(NSSC)
2.脉冲激光模拟单粒子效应的试验研究进展
2.1 激光有效能量与重离子LET阈值对应关系

图3. 激光锁定(左)/翻转(右)有效阈值能量与重离子LET阈值对应关系曲线
Figure3. Effective laser energy with heavy ionthreshold LET, single event latch-up(left)/single event upset(right)
2.2 脉冲激光正面辐照试验图像传感器单粒子效应
厂商工艺线要求,该0.18μm工艺器件有4层金属布线,要求金属布线覆盖芯片面积的65%,芯片设计师实际设计时金属布线覆盖的整个芯片面积只有约50%。通过设计反射率光路,测得器件表面反射的激光能量约为60%,且器件表面钝化层会让激光能量损失掉[17](0.685至0.950之间,均值为0.8175,取均值),所以表面入射的激光能量到达有源区时的有效能量为表面入射能量的0.4×0.8175=0.327。通过扫描测试,测得表面入射能量为1600pJ时芯片发生锁定,则到达有源区的激光有效能量为1600pJ×0.327=523pJ,由图3(左)中激光有效能量与LET值对应关系,则对应的LET值为(43.2±10.1)MeV·cm2·mg-1[18,19],与重离子给出的小于37 MeV·cm2·mg-1,激光试验给出的LET值阈值范围与重离子给出的LET阈值有交叉。

图4. 利用脉冲激光正面模拟试验图像传感器单粒子锁定效应
Figure4. Single event latch-up of CMOS image sensor byfront-side pulsed laser
2.3 脉冲激光模拟试验FPGA单粒子效应
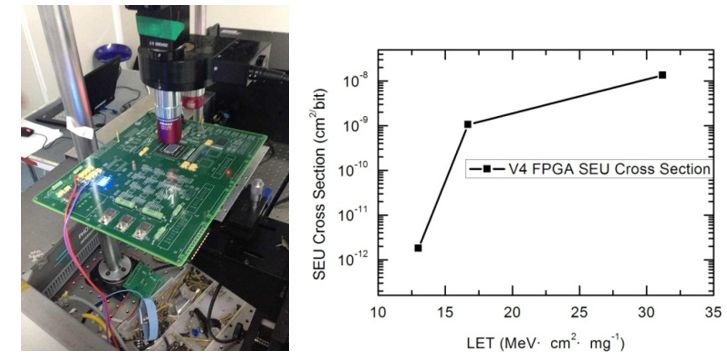
图5. 利用脉冲激光模拟试验FPGA单粒子翻转效应
Figure5. SEU of FPGA by pulsed laser simulating testing
2.4 电路系统抗单粒子翻转EDAC验证试验
选取一款CY7C1061DV33SRAM作为被测试对象,CY7C1061DV33是一款工业级54pin TSOP封装的SRAM,正常工作电压为3.3V。利用脉冲激光触发单粒子翻转效应,并利用开发的EADC验证纠错效果。
2.5 单粒子锁定对ADC输出影响试验
选取一款工业级ADC作为被测试对象,主要测试单粒子锁定效应对其输出的影响。AD7476芯片是一款6-leadSOT-23 封装的串行AD转换芯片,工作电压为2.35V到5.25V,SPI接口,电源电压做参考电压,由片选、时钟和数据接口完成通信。

(a)

(b)

(c)
图6单粒子锁定对ADC输出影响试验结果
Figure 6. Results of SEL effects for ADC outputs
2.6 电路系统抗单粒子锁定验证试验
利用脉冲激光扫描辐照时观测GP1的工作状态。当GP1正常工作时,测量其2路脉冲信号的时间间隔,并完成内部校准后输出“完成”标志信号,通过8位数据总线读出32位测量结果。如果在脉冲输入信号正常给定的情况下无“完成”标志信号出现或 32 位测量结果出现大幅跳动,并伴随供电电流激增,则认为器件发生了单粒子锁定。
为了保证 GP1 芯片的功能在锁定后不被损坏,在芯片的供电端串联限流保护电阻。当发生锁定时,供电电流会大增,在限流电阻处形成压降,使得 GP1 芯片供电电压下降,锁定电流维持低值。更换不同限流保护电阻,进行 GP1 芯片锁定试验。增加了24Ω限流保护电阻的长时间工作试验,在 GP1 芯片发生锁定后供电电压拉低,并且在持续锁定电流的通电状态下功能中断 30min后断电再重启仍能正常工作。图7(a)为增加 24Ω 限流保护电阻的 TDC-GP1 锁定电流波形。在采用限流电阻的同时适当提高器件工作电压,在发生锁定时,控制锁定电流为较小值,同时锁定电流导致的压降在器件可以容忍的范围,取得较好的设计效果,如图7(b)所示。

(a)

(b)
图7 TDC-GP1器件(a)增加24Ω限流电阻和(b)同时提高工作电压时的锁定电流波形
Figure7. TDC-GP1 (a) 24Ω resistance for currentlimitation (b) raising working voltages for SEL current
2.7 器件单粒子效应敏感区域定位试验


图8 DC-DC组件SET敏感区域及各功能单元输出
Figure 8. SET sensitivity areas and functional unitsoutput of DC-DC

图9 DC-DC组件SEB敏感区域定位
Figure 9. DC-DC single event burnout (SEB) sensitivityarea orientation
3. 结论
PDF版本请点击底部“阅读原文”
参考文献
[1] 韩建伟,张振龙,封国强,等。单粒子锁定极端敏感器件的试验及对我国航天安全的警示 [J]。航天器环境工程,2008,25(3):265-267。(中文期刊)
[2]THOMAS E, JOSEPH M. Extreme latchup susceptibility in moderncommercial-off-the-shelf (COTS) monolithic 1M and 4M CMOS static random accessmemory (SRAM) devices [C]// Radiation Effects Data Workshop of IEEE. [S.l]:IEEE,2005,1-7.(会议)
[3]Pascal Fouillat, Vincent Pouget, Dale McMorrow, et al. Fundamentals of thePulsed Laser Technique for Single-Event Upset Testing, Radiation Effects onEmbedded Systems, 2007, 121-141.(外文期刊)
[4] R Jones, A MChugg, C M Jones, P H Duncan, Comparison Between SRAM SEE Cross-Sections FromIon Beam Testing With Those Obtained Using A New Picosecond Pulsed LaserFacility, RADECS99, Session E:11-13. (会议)
[5]POUGET V, FOUILLAT P, LEWIS D, et al. Laser cross measurement for theevaluation of single event effects in integrated circuits[J]. MicroelectronicsReliability, 2000,40(2): 1 371-1375. (外文期刊)
[6] Stephen P. Buchner, Florent Miller,Vincent Pouget, et al. Pulsed-Laser Testing for Single-Event EffectsInvestigations, IEEE TRANSACTIONS ON NUCLEAR SCIENCE, 2013, 1-24. (外文期刊)
[7] Pouget V, Douin A, Foucard G, et al.Dynamic testing of an SRAM-based FPGA by time-resolved laser faultinjection[C]//IOLTS. 2008: 295-301. (外文期刊)
[8] Pouget V, Lewis D, Fouillat P. Time-resolved scanning ofintegrated circuits with a pulsed laser: application to transient faultinjection in an ADC[J]. Instrumentation and Measurement, IEEE Transactions on,2004, 53(4): 1227-1231.(外文期刊)
[9] DARRACQF, LAPUYADE H, BUARD N, et al. Backside SEU laser testing forcommercial-off-the-shelf SRAMs [J]. IEEE Transactions on Nuclear Science, 2002,49(6) :2977-2 983.(外文期刊)
[10] MELINGER J, BUCHNER S, MCMORROW D,et al. Critical evaluation of the pulsed laser method for single event effectstesting and fundamental studies [J]. IEEE Trans Nucl Sci, 1994, 41: 2575. (外文期刊)
[11] 黄建国韩建伟,脉冲激光诱发单粒子效应的机理, 中国科学G辑物理学力学天文学2004,34(2):121-130。(中文期刊)
[12] 封国强,马英起,张振龙,等.光电耦合器的单粒子瞬态脉冲效应研究[J]..原子能科学技术,2008,42(增刊):36-42。(中文期刊)
[13] Dodds N A, Hooten N C, Reed R A, etal. SEL-sensitive area mapping and the effects of reflection and diffractionfrom metal lines on laser SEE testing [J]. Nuclear Science, IEEE Transactionson, 2013, 60(4): 2550-2558. (外文期刊)
[14] Y.-T. Yu, J.-W. Han, G.-Q. Feng,M.-C, R. Chen. Correction of single event latchup rate prediction using pulsedlaser sensitivity mapping test. IEEE Trans. Nucl. Sci., 2015.(外文期刊)
[15] Yongtao Y, Guoqiang F, Rui C, Jianwei H. Laser SEU sensitivity mappingof deep submicron CMOS SRAM. Journal of Semiconductors, 2014. (外文期刊)
[16] 余永涛,封国强,陈睿,等。CMOS SRAM 器件单粒子锁定敏感区的脉冲激光定位试验研究 [J]。航天器环境工程,2014,31(2):150-153。(中文期刊)
[17] 田恺, 曹洲, 薛玉雄, 等. 器件表面钝化层对脉冲激光等效重离子LET 值的影响[J].真空与低温, 2007, 13(2): 102-106. (中文期刊)
[18] 黄建国, 韩建伟. 脉冲激光模拟单粒子效应的等效LET计算[J].中国科学G辑,2004,34(6): 601-609. (中文期刊)
[19] 田恺, 曹洲, 薛玉雄, 等. 脉冲激光能量等效重离子LET研究[J].原子能科学技术, 2010, 44(4): 489-493. (中文期刊)
[20] 颜洪雷,黄庚华,王海伟,等。TDC-GP1 器件单粒子锁定效应的脉冲激光模拟试验研究。航天器环境工程, 2014,31(2):146-149。(中文期刊)
PDF版本请点击底部“阅读原文”
做实验,搞科研,学知识
▼
