科普 | 一文读懂电子束光刻技术与MEMS制造
以下文章来源于中国科学院北京分院 ,作者曹富林
传播科学,服务公众。


MEMS与我们的生活息息相关
MEMS技术广泛应用于国防航天、光电影像、生化医疗、微波通讯及汽车工业等各个领域。例如汽车上用的微型加速度计、投影仪中用的微镜、打印机中用的微型喷头,极大地方便了人们的生产生活。下图是利用微加工技术制造的微型指叉式加速度计,它是标准的平板电容器。加速度的变化带动活动质量块的移动从而改变平板电容两极的间距和正对面积,通过测量电容变化量来计算加速度,在汽车电子中被广泛应用。

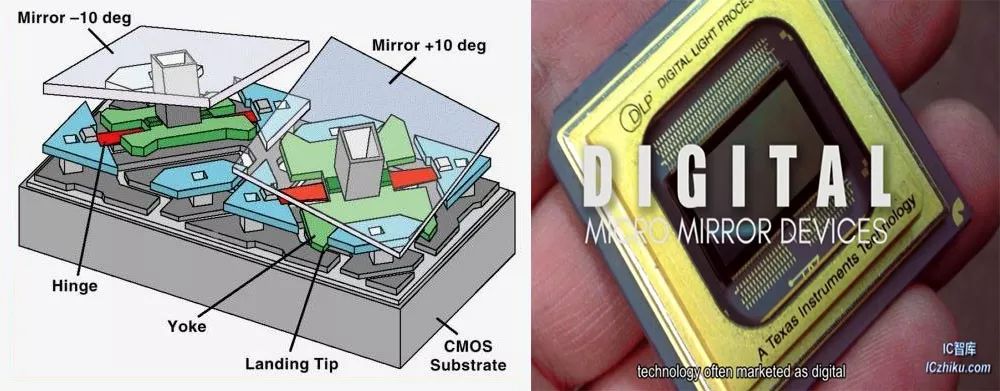
数字微镜
体积如此小且功能高度集成的装置是如何制造出来的呢?MEMS的制造广泛的借鉴了集成电路中的光刻、刻蚀以及镀膜等工艺。光刻是整个微加工工艺中技术难度最大,也是最为关键的技术步骤。所谓光刻就是通过对光束进行控制,在一层薄薄的光刻胶表面“刻蚀”出我们需要的图案,光束照过的位置光刻胶的化学性质会发生变化,通过显影液的浸泡会使照射过的部分去除(正胶)或者保留(负胶),流程示意图如图所示。
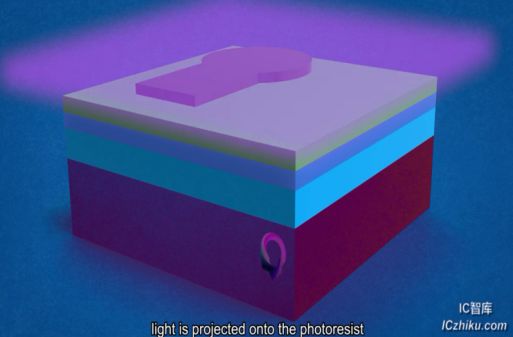
曝 光


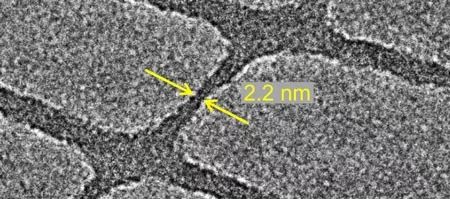
电子束曝光2.2nm线宽

电子束光刻的主要原理是利用高速的电子打在光刻胶表面,使光刻胶的化学性质改变。在电子束光刻中电子的产生方式有两种,一种是热发射,另一种是场发射。热发射是通过对阴极材料高温加热,使电子获得足够的能量从阴极中逸出;场发射是将阴极置于高强度电场中,利用电场对电子的强作用力使电子脱离原子核的束缚。直写式电子束的曝光原理是将聚焦的电子束斑直接打在光刻胶的表面,加工中不需要成本高昂的掩模版和昂贵的投影光学系统,其加工方式也更为灵活,适合小批量器件的光刻,在实际中应用更为广泛。
电子束光刻的分类
电子束光刻按照曝光方式划分可分为两种,投影式曝光与直写式曝光。投影式曝光通过控制电子束照射掩模图形,将掩模图形投影至光刻胶表面,把掩模板上的图案转移到光刻胶上,原理类似于照相机,拍摄对象好比掩模板,光刻胶就像是胶卷,通过光线的照射把拍摄对象投影到胶卷上,如图所示。

直写式光刻不需要掩模版,通过磁场直接控制电子束斑按照预设的轨迹在光刻胶表面照射,完成图案转移,就像是画画,铅笔类似于电子束,纸类似于光刻胶,而我们的手类似于磁场,通过手控制铅笔的移动完成图画的绘制。

直写式电子束曝光
电子束光刻的基石:光刻胶

常用电子束光刻胶基本特性
基于PMMA的电子束光刻工艺流程
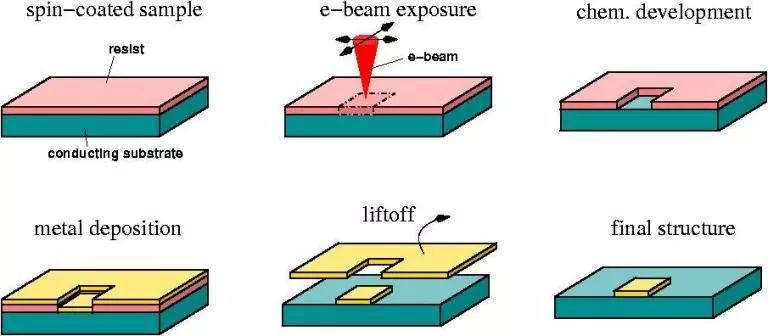
PMMA电子束光刻流程
(1) 基片表面预处理
硅片表面粗糙度、热膨胀系数低,在MEMS光刻中通常采用硅片作为基底。为确保光刻胶涂覆均匀,需要使用化学溶液对表面进行清洗,后用去离子水漂洗并干燥。
(2)旋涂光刻胶
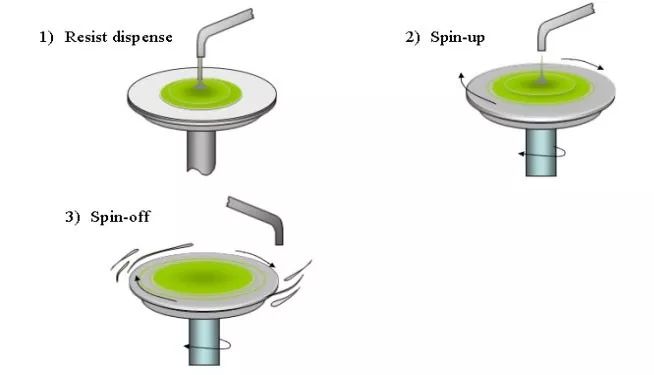
(3)前烘
前烘可使光刻胶中的溶剂挥发,使其与硅片之间的结合力更强。前烘过度则会导致胶膜硬化,胶膜硬化不利于其内应力的消除,前烘不足溶剂挥发不完全,胶膜出现缺陷,显影时存在浮胶现象。
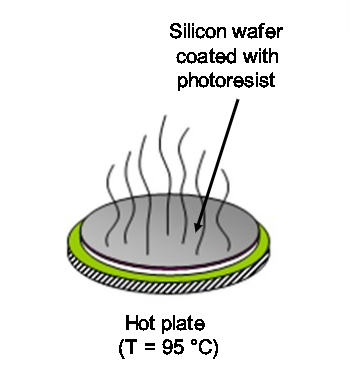
(4)曝光
曝光是电子束光刻工序中最复杂的一步,曝光的图形尺寸精度直接影响零件的尺寸精度。曝光剂量对曝光效果的影响最大,若曝光剂量不足,显影时会出现光刻胶残留在硅片表面,显影图案不完整、形状不规则。

(a)曝光不足 (b)正常曝光
若曝光剂量增大到一定程度,被曝光区域的 PMMA 光刻胶将呈现出负胶性质,显影后无法被去除。下图是笔者在实验室利用电子束直写技术光刻的笛卡尔心脏线,输入心脏线参数方程,并设置较大的曝光剂量,使得PMMA显示出负胶性质,显影后得到心脏线图形。

电子束光刻笛卡尔心脏线
(5)显影
显影液可溶解光刻胶被曝光的部分(正胶)或未被曝光的部分(负胶),是产生图形的关键工艺。显影工艺的关键是显影液类型的确定和显影时间的控制,此外,显影液的配比、温度也会对图形质量产生明显影响。
(6)坚膜
坚膜又称硬烘,目的是通过烘烤使光刻胶胶模中残留的显影液和定影液挥发出来,同时提高光刻胶与基片之间的结合力,烘烤的温度时间视光刻胶的种类及旋涂后的胶膜厚度而定,如果坚膜不到位可能会出现胶膜倒塌的情况,如下图所示。

胶模倒塌
(7)金属沉积及去胶
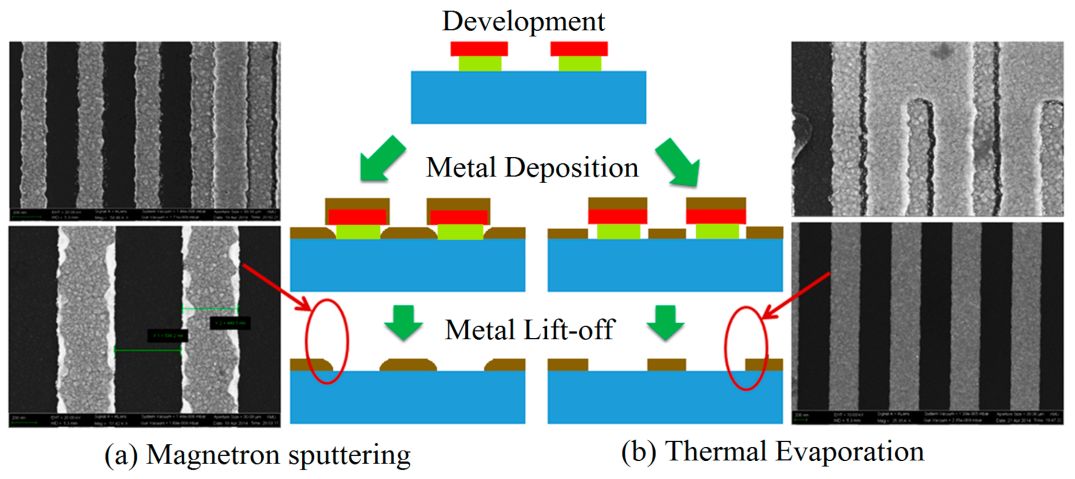
总 结
电子束光刻是迄今为止分辨率最高的光刻技术,由于直写式的方法不需要昂贵且费时的掩模版,加工灵活,已经引起广泛的重视,随着产业界对MEMS技术要求的不断提高,电子束光刻已逐渐成为MEMS工艺的新支柱。(文中部分图片来源于网络)


编辑:橘子大人