【特色服务】米格实验室-深能级瞬态谱(DLTS)测试技术与服务
一
原理介绍
深能级瞬态谱(Deep Level Transient Spectroscopy)是半导体领域研究和检测半导体杂质、缺陷深能级、界面态等的重要技术手段。根据半导体P-N 结、金-半接触结构肖特基结的瞬态电容(△C~t)技术和深能级瞬态谱(DLTS)的发射率窗技术测量出的深能级瞬态谱,是一种具有极高检测灵敏度(检测灵敏度通常为半导体材料中掺杂济浓度的万分之一)的实验方法,能检测半导体中微量杂质、缺陷的深能级及界面态。通过对样品的温度扫描,可以给出表征半导体禁带范围内的杂质、缺陷深能级及界面态随温度(即能量)分布的DLTS 谱。同时DLTS测试软件集成多种全自动的测量模式及全面的数据分析,可以确定杂质的类型、含量以及随深度的分布。
二
主要特点
特别适用Si、GaAs、SiC、GaN基的SBD、MOS、MIS、PN结界面态、深能级位置及浓度;
三
仪器设备

DLTS采用德国Phystech公司
型号:FT 1230 HERA DLTS System
技术参数
电压范围:±20.4 V;
脉冲宽度:1 µs - 1000 s;
灵敏度 0.01fF;
温度范围:290K~710K。
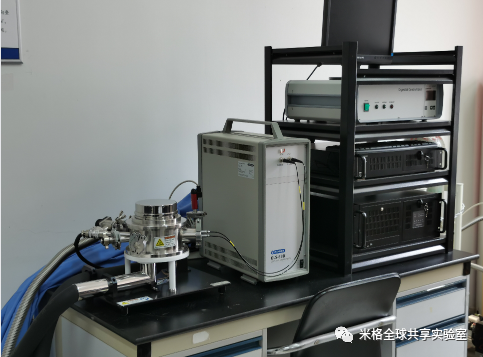
技术参数
脉冲发生器:电压范围:+20V;
电流范围,最大10mA;
电压分辨率:10mV;
脉冲宽度:0.05us-65ms;
电容测试架:100mV@1Mhz;
分辨率:0.01pF;
温度范围:液氦-700K;液氮-700K;
锁相放大器:频率:0.1Hz-2.5kHz;
输出信号:0.01mV-1000mV;
相角稳定性:<0.001o
仪器功能:温度扫描,频率扫描,俘获截面测试,杂质浓度随深度的变化曲线,I-V和C-V曲线的特性,光学激发和电流DLTS,MOS软件分析功能,Arrhenius数据库。
四
测试须知
1、样品大小:<20mm*20mm;电极直径:>600微米;电极距离:>1mm或者在两面。
2、样品结构
(1)肖特基结构;
(2)P/N结结构(p/n+或者n/p+);
(3)MIS(MOS)结构。
测试温度78K~700K,最好提供样品结构示意图
3、测试需要提供参数
(1)样品标注正负极;
(2)电流,电压最大值;
(3)结的面积。对于肖特基,即肖特基金属的面积;对于PN结,即PN结的面积,对于MIS(MOS),即栅介质上金属的面积;由于测试探针针尖面积约500平方微米,故要求结的面积要大于针尖面积。
五
测试过程
1、b1变温扫描曲线:多种内置采样函数,对每一个温度点的每一种测试条件进行采样并得到如下页图所示的变温扫描曲线,由于半导体器件内部的载流子会在不同的能级上面来回跳动,因此浅能级的必须要被降低能量,从而避免对真正的深能级造成影响,根据载流子温度越低,活跃性越差的特点,进行变温扫描测试,得到DLTS变温谱线。

2、Arrhenius拟合线:对变温扫描曲线进行解析,得到如图所示的Arrhenius拟合线,通过对该拟合线的分析,得到变温扫描测试下的深能级缺陷。
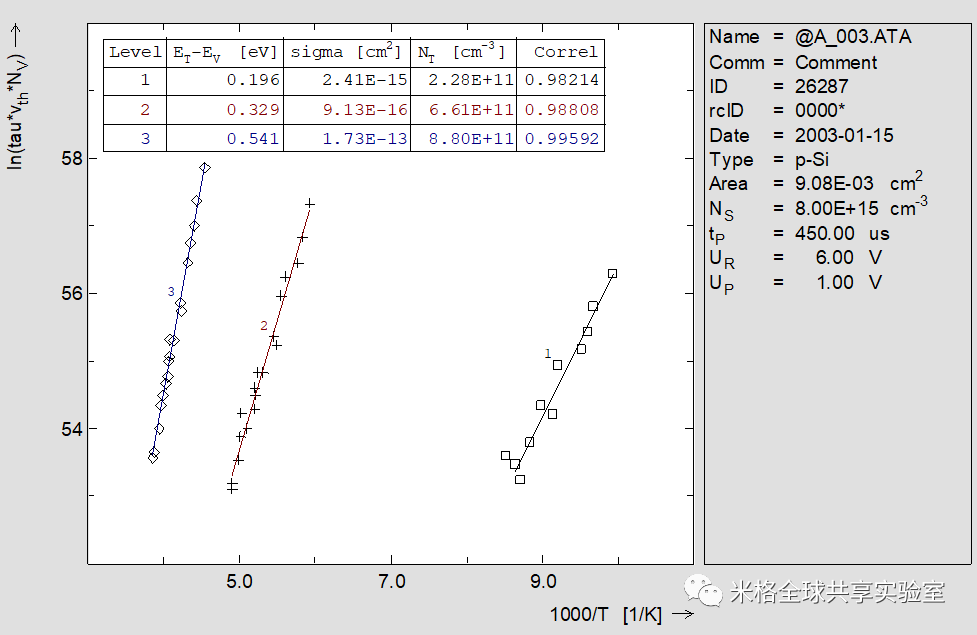
3、变电压扫描曲线:偏置电压改变
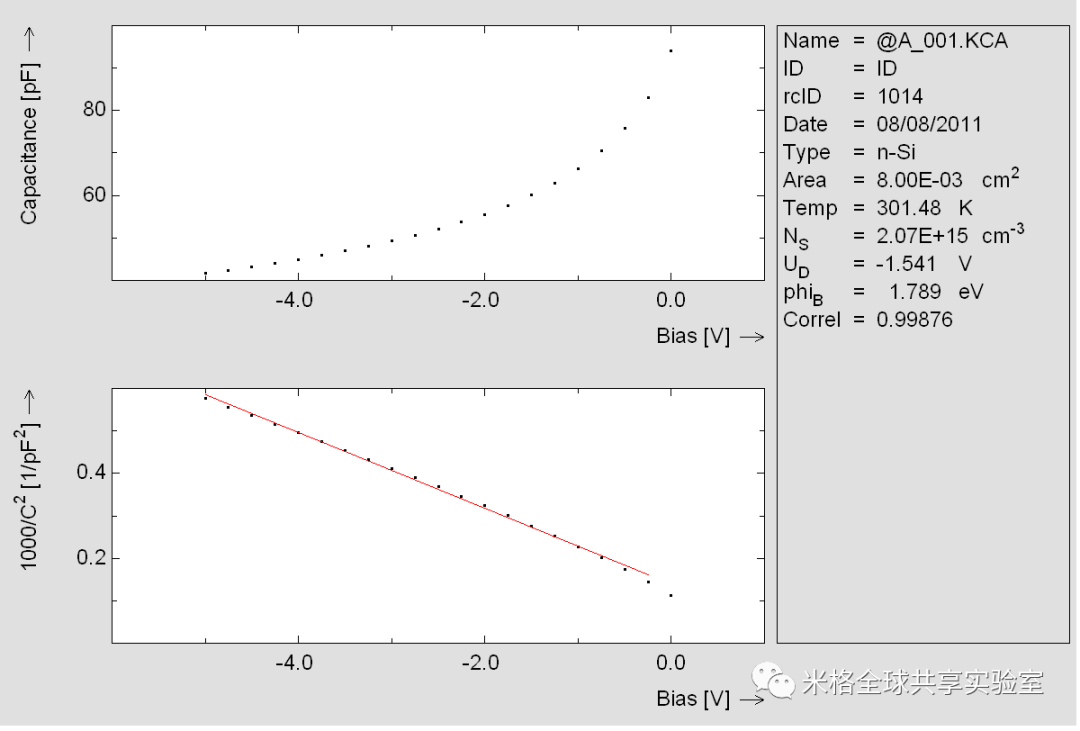
六
案例与分析

图1[1] 60COγ射线辐照条件下,有/无Si3N4钝化层的LPNP双极型晶体管深能级瞬态图谱
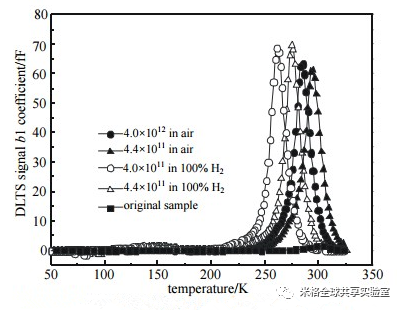
图2[2] 不同气氛下1MeV电子辐照GLPNP晶体管时不同辐照注量的DLTS谱
[1] 杨剑群, 董磊, 刘超铭, 等. Si3N4钝化层对横向PNP双极晶体管电离辐射损伤的影响机理[J]. 物理学报, 2018,67(16):370-376.
[2] 李兴冀, 陈朝基, 杨剑群,等. 氢气气氛下横向PNP晶体管电离损伤行为[J]. 太赫兹科学与电子信息学报, 2017, 15(4):690-695.


