【光刻百科】光学邻近效应修正 Optical Proximity Correction (OPC)
光学邻近修正(Optical Proximity Correction,OPC)是一种光刻分辨率增强技术[1]。OPC主要在半导体器件的生产过程中使用。在光刻工艺中,掩膜上的图形通过曝光系统投影在光刻胶上,由于光学系统的不完善性和衍射效应,光刻胶上的图形和掩模上的图形不完全一致。这些失真如果不纠正,可能大大改变生产出来的电路的电气性能。光学邻近效应修正(Optical ProximityCorrection,OPC)就是使用计算方法对掩膜上的图形做修正,使得投影到光刻胶上的图形尽量符合设计要求[2]。
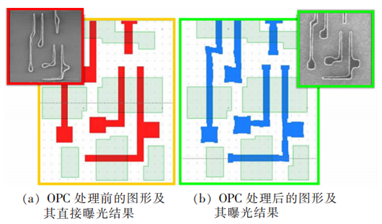
图1 OPC处理前后的图形及其曝光结果
应用条件
一般来说,当晶圆上的线宽小于曝光波长时,必须对掩模上的图形做邻近效应修正。例如,使用248nm波长光刻机,当图形线宽<250nm时,必须使用简单的修正;当线宽<180nm时,则需要非常复杂的修正。使用193nm波长光刻机,当最小线宽<130nm时,就必须做图形修正[2]。
基于经验的光学邻近效应修正
光学邻近效应修正首先于250nm技术节点被引入报道提光刻工艺中。OPC软件根据事先确定的规则对设计图形做光学邻近效应修正。这种方法的关键是修正规则,它规定了如何对各种曝光图形进行修正。其形式与内容会极大的影响OPC数据处理的效率和修正的精度。修正规则是从大量实验数据中归纳出来的,随着计算技术的发展,修正规则也可以通过计算的方法产生。修正规则都是在一定光照条件下产生的。如果工艺条件发生了变化,这些修正规则必须重新修订[2]。
基于模型的光学邻近效应修正
基于模型的光学邻近效应修正从90nm技术节点开始被广泛应用。它使用光学模型和光刻胶化学反应模型来计算出曝光后的图形。该方法的关键是建立精确的光刻模型,包括光学模型和光刻胶模型,为达到较高的计算速度,这些模型都采用近似模型,其中包含一系列参数,需要实验数据来进行拟合,以保证模型的精确度。显然实验数据越多,模型拟合越精确。但是太多的测试图形会使得晶圆数据的收集量太大。因此,测试图形的设计非常关键[3]。
参考文献:
[1]Calibre OPC and PSM,http://s3.mentor.com/public_documents/datasheet/products/ic-manufacturing/computational-lithography/calibre_ret.pdf
[2]韦亚一,超大规模集成电路先进光刻理论与应用,科学出版社,2016,343-360
[3]韦亚一,粟雅娟,刘艳松,先导光刻技术中的光学邻近效应修正,微纳电子技术,2014,51(3):186-193
往期回顾:
【光刻百科】硬掩模,Hard Mask
【光刻百科】前烘 Photoresist Prebake
【光刻百科】光学邻近效应 Optical Proximity Effect (OPE)
【光刻百科】显影液 Developer
【光刻百科】光源掩模协同优化 Source Mask Optimization (SMO)
【光刻百科】边缘粗糙度 Line Edge Roughness (LER)
【光刻百科】线宽粗糙度 Line Width Roughness (LWR)
【光刻百科】套刻误差 Overlay
【光刻百科】掩模误差增强因子 Mask Error Enhancement Factor,MEEF
【光刻百科】计算光刻 Computational Lithography
【光刻百科】掩模 Mask
【光刻百科】纳米压印光刻 Nanoimprint Lithography (NIL)
【光刻百科】边缘放置误差 Edge Placement Error (EPE)
【光刻百科】投影式光刻机 Projection Photoetching Machines
【光刻百科】双极照明 Dipole Illumination
【光刻百科】四极照明 Quadra Illumination
【光刻百科】抗反射涂层 Anti-Reflection Coating (ARC)
【光刻百科】设计工艺协同优化 Design Technology Co-optimization (DTCO)
【光刻百科】化学放大胶 Chemically-amplified Resist (CAR)
【光刻百科】曝光后烘烤 Post Exposure Bake (PEB)
【光刻百科】负显影 Negative Tone Development (NTD)
【光刻百科】光致酸产生剂 Photo Acid Generator (PAG)
【光刻百科】对准标记 Alignment Mark
【光刻百科】光刻胶边缘修复 Edge Bead Removal
【光刻百科】分辨率增强技术 Resolution Enhancement Technique (RET)
【光刻百科】光强对数斜率 Image Log Slope (ILS)
【光刻百科】相移掩模 Phase Shift Mask (PSM)
【光刻百科】刻蚀负载效应 Etch Loading Effect
【光刻百科】双重曝光 Double Exposure (DE)
【光刻百科】自对准双重成像技术 Self-aligned Double Patterning (SADP)
【光刻百科】焦距能量矩阵 Focus Energy Matrix (FEM)
【光刻百科】衍射光学元件 Diffractive Optical Elements (DOE)
【光刻百科】溶剂退火 Solvent annealing(SA)
【光刻百科】设计规则检测 Design Rule Check, DRC
【光刻百科】电路规则检查 Layout versus schematic(LVS)
【光刻百科】工艺窗口 Process Window (PW)
【光刻百科】自由形式光源 Freeform Source (FFS)
【光刻百科】反应离子刻蚀 Reactive ion etching, RIE
【光刻百科】Inverse Lithography Technology (ILT)
【光刻百科】去保护反应(Deprotection Reaction)
【光刻百科】聚焦深度 Depth of Focus (DOF)
【光刻百科】化学外延法 Chemical Extension
【光刻百科】嵌段共聚物分相 Block Copolymer Phase
【光刻百科】微沟槽效应 microtrenching effect
【光刻百科】前道工艺(Front end of line, FEOL)
【光刻百科】后道工序 Back end of line(BEOL)
【光刻百科】波段外辐射 Out Of Band Radiation, OOB
【光刻百科】掩模三维效应 Mask 3D Effect (M3D)
【光刻百科】掩模三维效应 Mask 3D Effect (M3D)
【光刻百科】集成掩模检测系统 Integrated Reticle Inspection System (IRIS)
【光刻百科】空间像测量系统 Aerial Image Measurement System (AIMS)
【光刻百科】二元掩模 Binary Intensity Mask (BIM)
【光刻百科】光刻胶三维效应 Resist 3D Effect
【光刻百科】工艺变化带宽 Process Variation Band (PV band)
【光刻百科】掩模阴影效应 (Mask Shadow Effect)
【光刻百科】传输图像传感器 (Transmission Image Sensor, TIS)
【光刻百科】空间像(Aerial Image)
【光刻百科】扇形照明(Quasar)
【光刻百科】光刻友好型设计(Lithography Friendly Design, LFD)
【光刻百科】曝光区域(Shot)
【光刻百科】器件隔离(Device Isolation)
【光刻百科】极紫外光刻机曝光系统(Exposure System of Extreme Ultraviolet Scanner)
【光刻百科】极紫外光源(Extreme ultraviolet light source)
【光刻百科】对准精度(Alignment Precision)
【光刻百科】光源极化 Illumination Polarization
【光刻百科】光刻缺陷 Defect
看完有什么感想?
请留言参与讨论!

【欢迎留言,欢迎转发】