DRAM,进入EUV时代!
半导体行业观察
最有深度的半导体新媒体,实讯、专业、原创、深度,50万半导体精英关注!专注观察全球半导体最新资讯、技术前沿、发展趋势。《摩尔精英》《中国集成电路》共同出品,欢迎订阅摩尔旗下公众号:摩尔精英MooreElite、摩尔芯闻、摩尔芯球
公众号


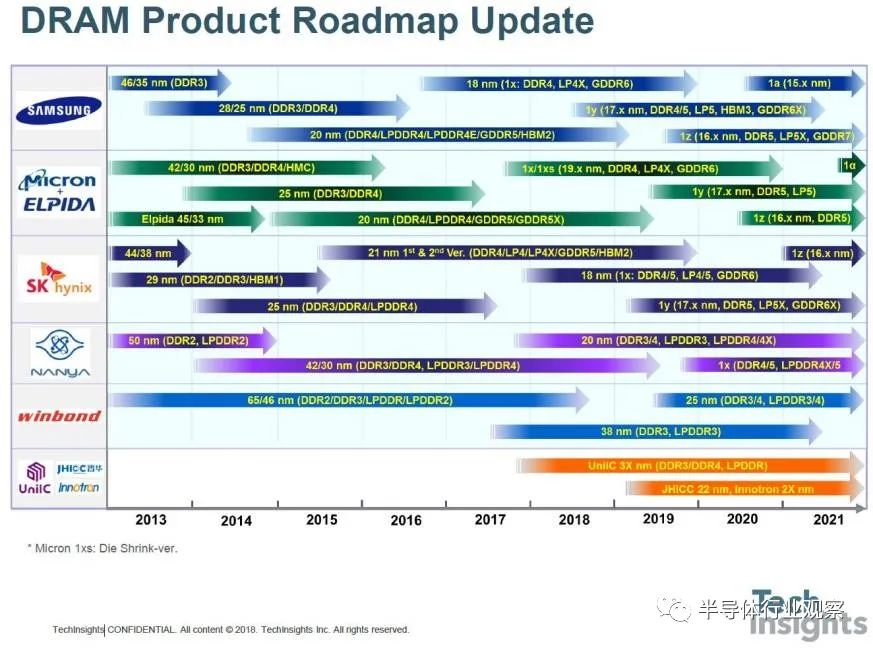

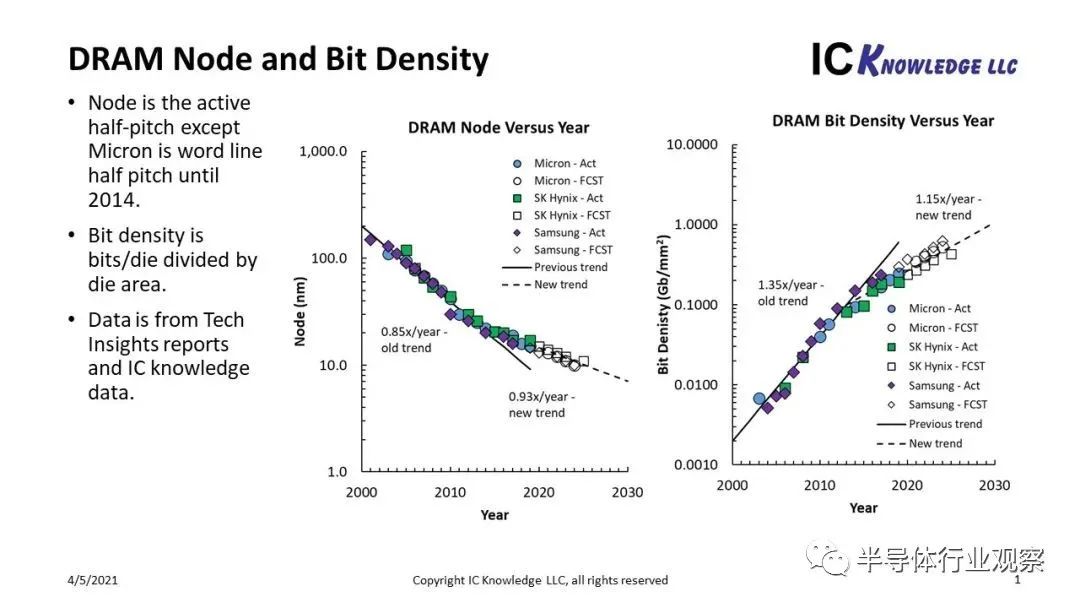


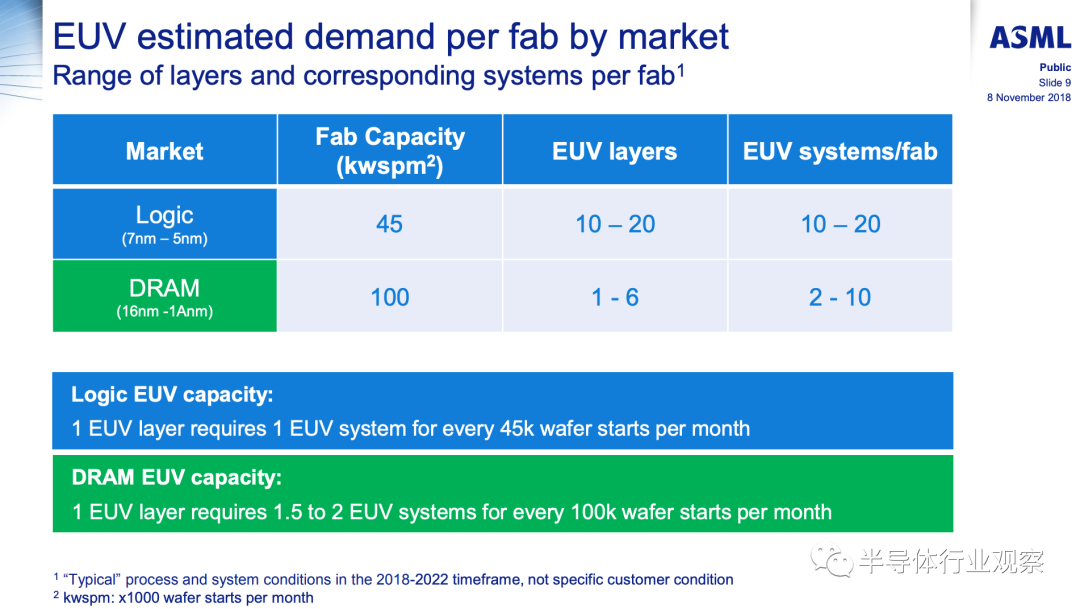
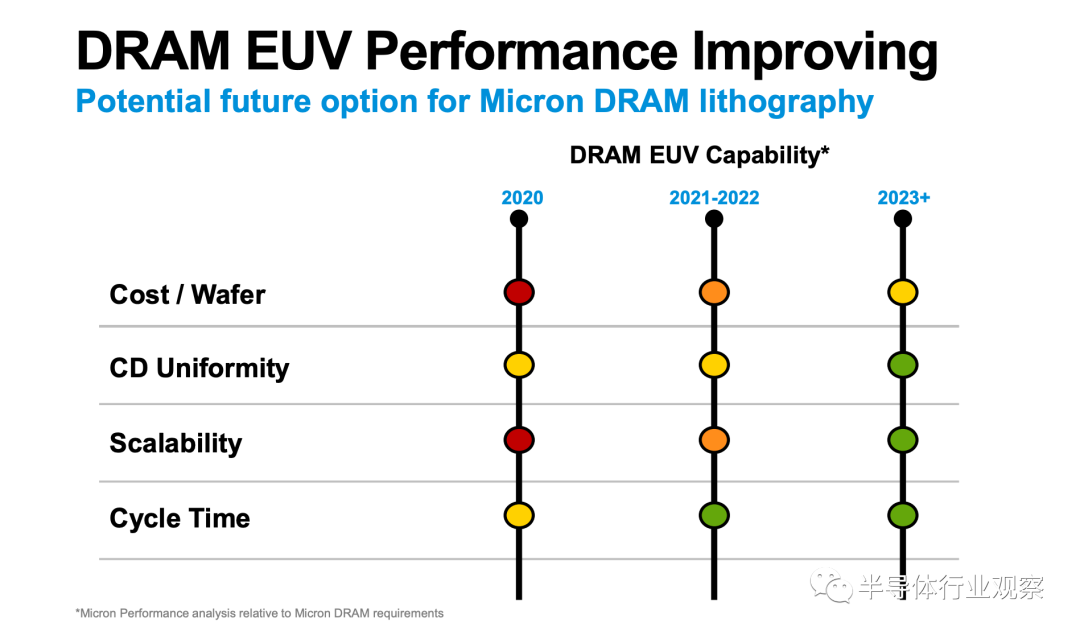


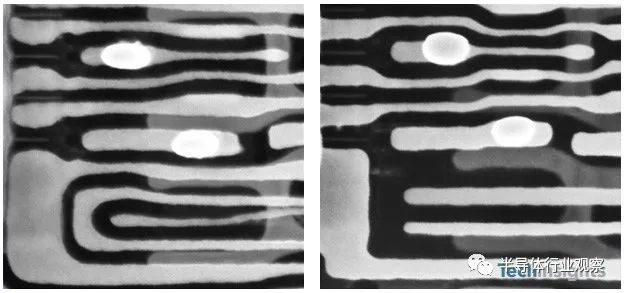
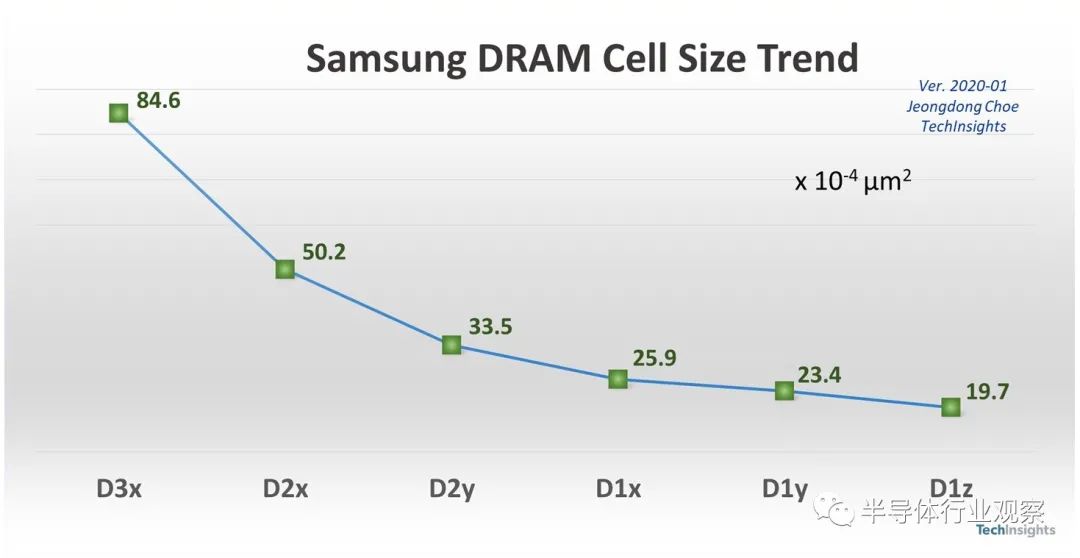



摩尔芯闻
您的半导体行业内参,每日精选8条全球半导体产业重大新闻解读,一天只花10分钟,享受CEO的定制内容服务。与30万半导体精英一起,订阅您的私家芯闻秘书!欢迎订阅摩尔精英旗下更多公众号:摩尔精英、半导体行业观察、摩尔App
公众号
*免责声明:本文由作者原创。文章内容系作者个人观点,半导体行业观察转载仅为了传达一种不同的观点,不代表半导体行业观察对该观点赞同或支持,如果有任何异议,欢迎联系半导体行业观察。
今天是《半导体行业观察》为您分享的第2734内容,欢迎关注。
推荐阅读
半导体行业观察

『半导体第一垂直媒体』
实时 专业 原创 深度
识别二维码,回复下方关键词,阅读更多
晶圆|集成电路|设备|汽车芯片|存储|MLCC|英伟达|模拟芯片
回复 投稿,看《如何成为“半导体行业观察”的一员 》
回复 搜索,还能轻松找到其他你感兴趣的文章!

