DRAM如何走出技术困局?
以下文章来源于半导体行业观察 ,作者L晨光
半导体行业观察 .
最有深度的半导体新媒体,实讯、专业、原创、深度,50万半导体精英关注!专注观察全球半导体最新资讯、技术前沿、发展趋势。《摩尔精英》《中国集成电路》共同出品,欢迎订阅摩尔旗下公众号:摩尔精英MooreElite、摩尔芯闻、摩尔芯球


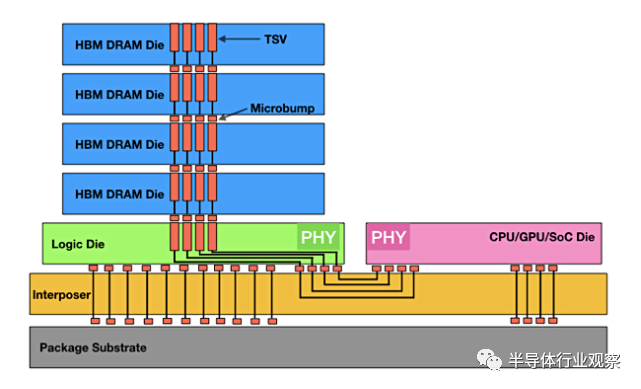
单片3D DRAM

晶圆减薄工艺
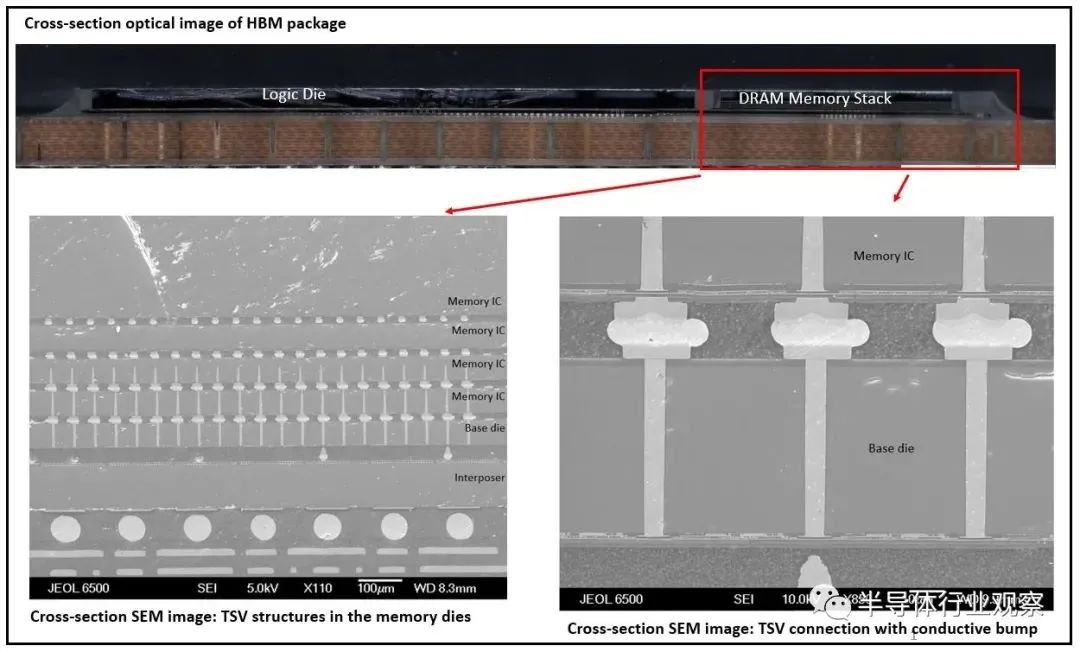
免责声明:本文系网络转载,版权归原作者所有。本文所用视频、图片、文字如涉及作品版权问题,请第一时间告知,我们将立即删除内容!本文内容为原作者观点,并不代表本公众号赞同其观点和对其真实性负责。
