不止EUV,先进芯片制造还有新选择

过去50多年里,半导体产业一直沿着摩尔定律向前发展,芯片工艺节点先后跨越了90nm、45nm、28nm、14nm,如今7nm和5nm已经实现量产,3nm和2nm是现在业界努力的方向,在这个不断演进的过程中,以光刻为基础的图形化工艺在其中扮演着至关重要的角色。光刻是芯片制造过程中最重要、最复杂、最昂贵的工艺,其精密度决定了芯片的制程,以及器件性能。
目前实现14nm工艺节点中的关键结构最常用的工艺是193nm沉浸式光刻结合自对准双图形(SADP)技术,但对于7nm及以下节点SADP技术已无法满足要求,必须采用四重甚至八重图形技术,这将导致成本大幅增加,而且掩膜版之间的套刻精度也难以控制。为此,学术界和工业界开始探索下一代光刻技术的解决方案。2020年国际器件与系统路线图(IRDS)将极紫外(EUV)光刻、导向自组装(DSA)和纳米压印光刻(NIL)列为下一代光刻技术的主要候选方案。EUV光刻我们都有所了解或者比较熟悉,在此我们将探讨半导体工艺技术中的另一个研发热点:DSA。
DSA先进光刻技术重回历史舞台?

DSA的研究进展#Human Progress
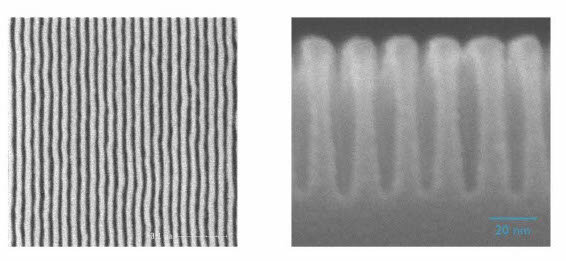
DSA工业化面临的挑战
转自:半导体行业观察
本文参考资料:胡晓华, 熊诗圣. 先进光刻技术:导向自组装[J]. 应用化学, 2021, 38(9): 1029-1078.
|推荐阅读|
© 滤波器 微信公众号
